断面観察試料を作る ―電子部品編―
電子部品のはんだ付け等による接合の不具合解析(技術ニュースVOL.31 No.2参照)は、(1)外観検査、(2)X線透過・CTや超音波探傷を用いた非破壊検査、(3)断面試料作製による接合面の観察・分析の順に行います。接合部の組織、元素分布、めっき厚等を知るためには、(2)までの非破壊検査だけでなく、断面試料を作製して観察する必要があります。
必要な箇所の断面試料を得るために、切り出しや樹脂埋め込みを繰り返して成形し、研磨により平滑な状態に仕上げます。
例えば、図1はBGA(Ball Grid Array)と呼ばれるはんだボールで接合するICを側面から観察したものです。ICと基板間に隙間があり、このまま切り出しや研磨を行うと加工の力によってはんだボール等が変形を起こす可能性があるため、この隙間にエポキシ樹脂を充填し、脱泡します。また、BGA等の電子部品が小型化しているため、研磨面は数10μm以下の位置精度が必要ですが、研磨しすぎると元には戻せないため、研磨と観察を慎重に繰り返し、図2の断面観察試料を作製します。
工業試験場では依頼試験だけでなく、研修を通じた断面試料作製による不具合解析の支援も行っていますので、ぜひご利用ください。
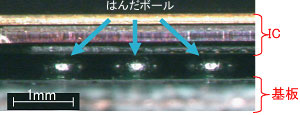 |
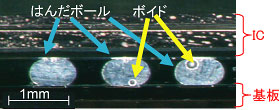 |
| 図1 BGAの側面からの写真(断面試料作製前) | 図2 BGA接合断面試料の写真 |
担当:電子情報部 筒口 善央(どうぐち よしてる)
専門:電子材料
一言:マイクロ接合の評価には欠かせません。お気軽にご相談ください。