はんだ付け評価技術の動向 ―小型電子部品、高密度実装への対応―
最近の携帯電話は小型かつ、カメラ、音楽プレーヤー、テレビ機能など多機能になっています。このような電子機器を実現するため、ここ数十年で電子部品には、本体からリード端子が出ている挿入部品に加えて、チップ部品をはじめとする表面実装部品が登場し、その体積は数千分の1にまで縮小しました。また、電子部品の変化に合わせて、はんだ付け方法も変わってきました。プリント基板のスルーホール(貫通穴)に差し込んだ挿入部品のリード端子を溶融はんだに浸漬してはんだ付けする方法「フロー実装」に加えて、表面実装部品をプリント基板のパッド上にソルダペースト(はんだ粉末とペースト状フラックスの混合物)で固定し、ソルダペーストを高温の炉で溶融させてはんだ付けする方法「リフロー実装」が登場しました(表1)。
表1 電子部品とはんだ付け方法の変化
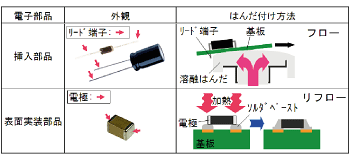
プリント基板への実装に使用するはんだやフラックス、電極のめっき材料の選定には、はんだのぬれ性(広がりやすさ)を評価することが有効です。評価方法としては、はんだ平衡法があります(図1:JIS C 60068-2-54、1990年制定)。挿入部品の場合は、リード端子を規定の深さまで溶融はんだ槽に浸漬させ、このとき部品に働く浮力と表面張力の合力の時間変化によって評価します。
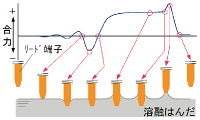
図1 はんだ平衡法
また、表面実装部品の場合は、リード端子を持たないことから溶融はんだ槽への浸漬が難しいため、電極をソルダペーストに差し込んでから加熱する方法をとっています(図2:JIS C 0099、2005年制定)。このうち、プロファイル昇温法では、電子部品を差し込んだままソルダペーストを温度プロファイルに合わせて加熱し溶融させ、はんだ平衡法と同様に部品に働く力の時間変化によってぬれ性を評価します。また、急加熱昇温法では、ソルダペーストに電子部品を差し込んだ状態から70±10℃/秒以上の昇温速度でソルダペーストを溶融させ、同様にぬれ性を評価します。
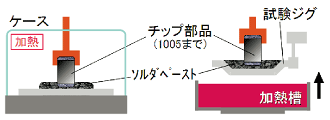
図2 プロファイル昇温法(左)と急加熱昇温法(右)
ところが、電子部品の高密度実装が進む中、上記規格では規定されていない、1005サイズ(1.0mm×0.5mm)より小型のチップ部品が登場してきました。そのような部品の場合は、溶融させた小さなはんだの球を用いて(はんだ小球平衡法)、チップ部品の電極を浸漬することで評価することになりました(図3:JIS C 60068-2-69、2007年制定)。
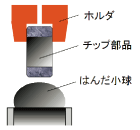 図3 はんだ小球平衡法 |
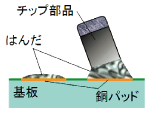 図4 チップ立ち |
工業試験場では、電子部品のはんだ付けの品質向上を支援するため、挿入部品に加えて、新たに表面実装部品のはんだぬれ性評価(JIS C 60068-2-69などに対応)が可能な試験機*を導入しました。これにより、0402サイズ (0.4mm×0.2mm)までのチップ部品に対応できるようになりました。
一方、小型電子部品をリフロー実装する際には、ぬれ性が関与しない、チップ立ち(図4:加熱むらなどにより片側が浮いてしまう不良)やブリッジ(はんだが他のはんだ付け箇所にまたがる不良)などの不具合が発生することがあります。工業試験場では、観察が困難な生産ラインのリフロー実装を再現し、ビデオ装置によって加熱中の様子を記録するリフローシミュレータ*を導入しました。
このような小型電子部品は携帯機器に採用されることでコストパフォーマンスが高まり、携帯機器以外の薄型テレビなどへの使用も広がり始めているため、今後、電子機器の更なる小型化や高機能化が進むものと考えられます。
*(財)JKA 補助事業(競輪補助金)により設備導入、お知らせ参照
担当:電子情報部 奥谷潤(おくたに じゅん)
専門:光電材料、電子機器の不具合解析
一言:はんだ付け評価に取り組みます。